

摘 要:
集成電路封裝行業(yè)的快速發(fā)展對粘片后產(chǎn)品的質(zhì)量與可靠性提出了更高的要求,粘片工藝對集成電路可靠性有著至關(guān)重要的影響。采用單一控制變量法,研究硅微粉含量對QFP(Quad Flat Package)封裝可靠性的影響;利用正交試驗工具,探究在粘片工藝中,不同的膠層厚度和膠層面積對QFP封裝后可靠性的影響。研究發(fā)現(xiàn),添加適量的硅微粉有助于提高環(huán)氧模塑料對QFP封裝后的可靠性;粘片工藝中,當(dāng)膠層厚度為30 μm、膠層面積大于或等于芯片面積時,QFP封裝后的可靠性最好。
隨著集成電路向高密度、高性能方向快速發(fā)展,對半導(dǎo)體元器件可靠性的要求越來越高,對于國內(nèi)絕大部分上規(guī)模的封測企業(yè)來說,其材料性能及設(shè)備能力完全具備制造的能力,技術(shù)和設(shè)備已不再是產(chǎn)品達到可靠性要求的主要關(guān)鍵限制因素,反而工藝過程成為了主要限制因素。傳統(tǒng)的芯片貼片工藝正在由共晶焊慢慢向點膠過渡,傳統(tǒng)的共晶焊接工藝中,焊料與襯底金屬間容易生成界面金屬間化合物 (IMC),對焊點的可靠性影響很大。當(dāng)金屬間化合物 IMC 層的厚度值增大到一定的臨界值時,金屬間化合物 IMC 層界面上的應(yīng)力集中現(xiàn)象嚴重,IMC 層界面間的空穴逐漸形成并不斷發(fā)展擴大,在 IMC 層的界面上容易發(fā)生斷裂破壞。
粘片又稱固晶,是通過介質(zhì) ( 膠體或合金片 ) 把芯片粘接在基板 ( 或管殼 ) 的指定區(qū)域,用粘片膠把芯片按照一定的方位裝置到引線框架襯底上并進行固化,形成熱通路或電通路,為后序的鍵合提供條件的工序。粘片工藝是 IC 器件和 MEMS 器件封裝工藝中一個重要的環(huán)節(jié)。在 IC 貼片中,該工藝主要影響 IC 的導(dǎo)熱性和可靠性;在 MEMS 電路中,粘片工藝還會造成 MEMS 器件運動部件和功能部件的損壞。粘片不僅具有工藝靈活、簡單、工藝溫度低和不需要助焊劑等優(yōu)點,而且其工藝設(shè)備也相對便宜、簡單,無論是工藝操作、工藝要求還是成本都比較低,應(yīng)用越來越廣泛。本文主要以 Henkel-8200T 這款粘片膠為研究對象,衡所華威的 GRX 為封裝材料,探究不同環(huán)氧模塑料、不同的膠層厚度 (BLT)、膠層面積對QFP 封裝可靠性的影響。
主要原料 :環(huán)氧樹脂,長春樹脂廠 ;酚醛樹脂,日本化藥株式會社;球型硅微粉,江蘇聯(lián)瑞新材料股份有限公司 ;催化劑,日本四國化成工業(yè)株式會社 ;QFP 框架,寧波康強股份有限公司;8200T 粘片膠,德國漢高。
主要設(shè)備 :高速混合機,GJ016 ;雙輥擠出機,BH679068 ;模壓機, SKMP002-250-7 ;超聲掃描儀,Sonix ;八溫區(qū)回流焊,Heller Industries。
EMC-GRX 主要原材料及配方如表1 所示,放入高速攪拌混合機中,高速混合 25 min。然后利用雙輥捏合機對粉料進行捏合,混煉溫度在 70~120 ℃ 之間,混煉后經(jīng)過壓輥、冷卻、粗粉碎、細粉碎后經(jīng)過 360° 旋轉(zhuǎn)混合,得到EMC-GRX1(Epoxy Molding Compound)、EMC-GRX2、EMC-GRX3 3 個樣品。
本次試驗的設(shè)計見表 2,采用單一控制變量法、利用正交試驗工具,研究不同模塑料、膠層厚度、膠層面積對QFP 封裝后分層的影響。芯片面積為 2.3 mm×2.3 mm,其中膠層面積大代表膠層面積大于2.3 mm×2.3 mm,膠層面積小代表膠層面積小于2.3 mm×2.3 mm,膠層面積常規(guī)代表膠層面積等于2.3 mm×2.3 mm。MSL3/MSL1( Moisture Sensitivity Level)的考核按照JEDEC標(biāo)準(zhǔn)。
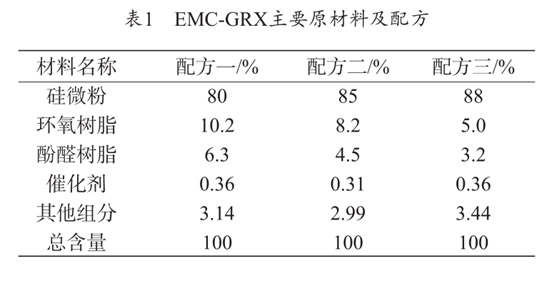
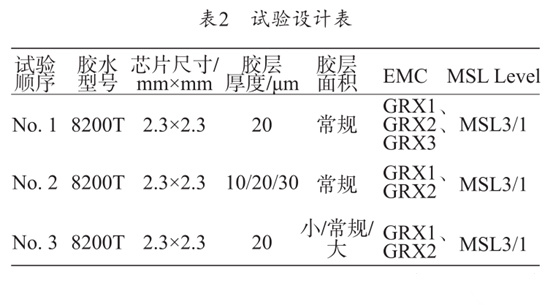
本次試驗的考核流程如圖 1 所示,封裝后的 QFP經(jīng)過沖筋打彎后在 125 ℃ 的條件下烘烤 4 h,然后按照 MSL3/1 的標(biāo)準(zhǔn)對元器件進行預(yù)處理,結(jié)束后經(jīng)過 3次八溫區(qū)的回流焊 ( 最高溫度為 260 ℃),最后用超聲掃描儀對元器件進行掃描。
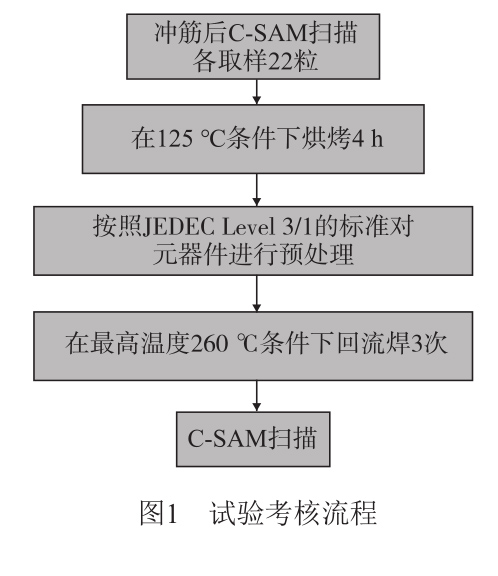
采用圖 1 的考核流程,得到 3 種模塑料在 MSL3/MSL1 后的分層考核結(jié)果,如表 3 所示。

從表 3 可以看出,GRX1 塑封料在 MSL3 后分層較少,MSL1 后分層嚴重 ;GRX2 塑封料在 MSL3 后芯片周圍無分層,MSL1 后芯片周圍嚴重分層;GRX3 塑封料在 MSL3/MSL1 后芯片周圍皆沒有發(fā)現(xiàn)分層。這主要是因為 GRX2/GRX3 兩款塑封料含有的硅微粉較 GRX1 的多,硅微粉增加,吸水率減少,故分層較好。模塑料吸入的濕氣會加速電子元器件的損壞,而且對元件焊接過程中的影響也非常巨大。這是因為元器件焊接都是在高溫下進行波峰焊或回流焊并由焊接設(shè)備自動完成的。當(dāng)將元器件固定到 PCB 板上時,回流焊快速加熱將在元器件內(nèi)部形成壓力,由于不同封裝結(jié)構(gòu)材料的熱膨脹系數(shù)不同,因此可能產(chǎn)生元器件封裝不能承受的壓力。當(dāng)將元器件暴露在回流焊接期間,由于環(huán)境溫度不斷升高,QFP 元件內(nèi)部的潮氣會產(chǎn)生足夠的蒸汽壓力,損傷或毀壞元件,嚴重的會造成“爆米花”效應(yīng)。選擇GRX1、GRX2這兩款塑封料為對象,研究 BLT、膠層面積對 QFP 封裝后可靠性的影響。
采用圖 1 的考核流程,得到 GRX1/GRX2 兩種模塑料在不同的 BLT 后 MSL3/MSL1 后的分層考核結(jié)果,如表 4 所示。

從表 4 可以看出,當(dāng) BLT 為 10 μm 時,兩款材料在 MSL3/MSL1 后芯片周邊分層很嚴重;當(dāng) BLT 為20 μm 時,兩款材料在 MSL3/MSL1 后的分層有所改善;當(dāng) BLT 為 30 μm 時,兩款材料在 MSL3/MSL1 后的芯片周圍分層效果最佳。不同 BLT 條件下芯片對框架的粘結(jié)強度如圖 2 所示,當(dāng) BLT 為 10 μm 時,粘結(jié)強度最差,BLT 為 30 μm 時,粘結(jié)強度最大,BLT 為20 μm 時,粘結(jié)強度介于兩者之間,粘結(jié)強度越強,分層越好。

采用圖 1 的考核流程,得到 GRX1/GRX2 兩種模塑料在不同的膠層面積下 MSL3/MSL1 后的分層考核結(jié)果,如表 5 所示。

從表 4 可以看出,在 BLT 為 20 μm 的條件下,當(dāng)膠層面積大于2.3 mm×2.3 mm時,芯片周邊分層最少,當(dāng)膠層面積小于 2.3 mm×2.3 mm 時,芯片周邊分層越差。膠層面積為 2.3 mm×2.3 mm 時,芯片周圍分層與膠層面積大于 2.3 mm×2.3 mm 時的效果相當(dāng)。

不同膠層面積下芯片對框架的粘結(jié)強度如圖 3 所示,可以看出,當(dāng)膠層面積大于 2.3 mm×2.3 mm 時,芯片與框架的粘結(jié)強度最大,達到 3899 N,當(dāng)膠層面積小于2.3 mm×2.3 mm時,芯片與框架的粘結(jié)強度最小,只有 2891 N,膠層面積等于 2.3 mm×2.3 mm 的粘結(jié)強度介于兩者之間。膠層面積大于 2.3 mm×2.3 mm 時的粘結(jié)強度雖比膠層面積等于 2.3 mm×2.3 mm 時的大,但兩者的分層效果卻相當(dāng)。這可能是由于膠層面積太大,膠溢在芯片周邊,過回流焊時膠中的揮發(fā)物揮發(fā)導(dǎo)致的。
總結(jié)
本文針對 QFN 元器件采用粘片工藝將芯片固定在基板上,以 Henkel-8200T 粘片膠為研究對象,衡所華威的 GRX 模塑料為封裝材料,探究不同模塑料、不同膠的 BLT 和不同膠層面積對 QFP 分層的影響。結(jié)果發(fā)現(xiàn):環(huán)氧模塑料中添加適量的硅微粉有助于改善QFP封裝后的分層性能 ;芯片與基板之間的粘結(jié)強度越大,分層的效果越好,當(dāng) BLT 為 30 μm 時較 BLT 為20 μm 和 BLT 為 10 μm 時的粘結(jié)強度大,故 QFP 的分層效果最好 ;當(dāng)膠水面積大于芯片面積時,芯片與基板之間的粘結(jié)強度越大,但膠水面積較大時,膠水會外溢在芯片周圍影響可靠性,故膠水面積大于或等于芯片面積時,兩者的 QFP 的分層效果相當(dāng),皆較膠水面積小于芯片面積時的分層效果好。