

摘 要:
文中通過(guò)數(shù)量多的工藝嘗試和產(chǎn)品證驗(yàn),解決了塑封BGA部件燒焊良率和靠得住性的問(wèn)題。隨著金屬封裝BGA(CCGA)的應(yīng)用,對(duì)金屬BGA(CCGA)燒焊橋連問(wèn)題施行敘述分析, 針對(duì)印刷網(wǎng)板厚度及張嘴形式的改進(jìn),提出一點(diǎn)改善金屬BGA(CCGA)燒焊品質(zhì)工藝辦法, 在實(shí)踐中獲得了令人滿意效果。
隨著電子產(chǎn)品向小規(guī)模化、便攜化、網(wǎng)絡(luò)化和高性能方向的進(jìn)展,對(duì)電路組裝技術(shù)和I/O引線數(shù)提出了更高的要求。因?yàn)榍驏抨嚵蟹庋b(Ball Grid Array,BGA)部件芯片的管腳散布在封裝的底面,所以可容受的I/O數(shù)很少。若將封裝外殼基板原東南西北引出的引腳成為以面陣布局的Pb/Sn凸點(diǎn)引腳,就可容受更多的I/O數(shù),且更容易運(yùn)用SMT與PCB上的布線引腳燒焊互連,這么要得BGA在電子商品生產(chǎn)領(lǐng)域取得了更加廣泛的應(yīng)用。隨著產(chǎn)品的要求,高等級(jí)的部件認(rèn)為合適而使用金屬外殼封裝的BGA(CCGA)也越來(lái)越多地應(yīng)用到產(chǎn)品中。CCGA封裝是BGA封裝的擴(kuò)展,用柱柵代替了球柵,大大緩解了部件基體與電路板熱體脹系數(shù)不般配帶來(lái)的熱疲乏問(wèn)題;其封裝方式還表決其具備耐高溫、耐高壓和高靠得住性的特別的性質(zhì),適合使用于更大尺寸和更多I/O的事情狀況,在軍事、航空和航大氣中的電荷子產(chǎn)品制作領(lǐng)域占領(lǐng)更加關(guān)緊的地位。因?yàn)檫@個(gè),為增長(zhǎng)金屬封裝BGA(CCGA)燒焊后焊點(diǎn)的品質(zhì)和靠得住性,就金屬封裝BGA(CCGA)燒焊工藝施行優(yōu)化研討,將為將來(lái)進(jìn)展起到很大效用。
本次SMT出產(chǎn)線,成功實(shí)現(xiàn)從了半自動(dòng)上板、半自動(dòng)涂覆焊膏、焊膏檢驗(yàn)測(cè)定、機(jī)器貼片、X-ray/爐前AOI檢驗(yàn)測(cè)定、真空氣相燒焊、爐后AOI檢驗(yàn)測(cè)定、在線ICT測(cè)試、半自動(dòng)下板。針對(duì)常用的各類元部件開(kāi)展了多次工藝嘗試,并運(yùn)用正交辦法對(duì)不一樣組合的工藝參變量燒焊了多塊包括阻容件、塑封BGA部件、FP/QFP封裝部件的嘗試板,均沒(méi)有顯露出來(lái)燒焊品質(zhì)問(wèn)題。但在燒焊包括金屬封裝BGA部件的電路板時(shí),燒焊后經(jīng)過(guò)X-ray檢查驗(yàn)看時(shí)發(fā)覺(jué)金屬封裝BGA部件發(fā)生焊點(diǎn)橋連(短路)。部件外觀如圖1所示。

針對(duì)顯露出來(lái)的問(wèn)題,運(yùn)用魚(yú)刺圖辦法對(duì)顯露出來(lái)故障的端由施行剖析,列出了所可能有關(guān)的因數(shù),如圖2所示。

該次認(rèn)為合適而使用的是半自動(dòng)印刷機(jī)配搭激光張嘴鋼網(wǎng)施行的錫膏印刷,假如鋼網(wǎng)張嘴過(guò)大,還是鋼網(wǎng)厚度過(guò)厚均會(huì)直接增加錫膏量,而過(guò)多的錫膏量在燒焊特殊情況直接影響橋連的發(fā)生(到現(xiàn)在為止鋼網(wǎng)的張嘴尺寸與PCB焊盤體積完全一樣,比例為100百分之百,鋼網(wǎng)厚度為0.13 mm)。
1)設(shè)施印刷壓力過(guò)大,會(huì)造成錫膏有沉陷的現(xiàn)象,因此要得焊盤上錫膏之間的間距變小。但假如印刷壓力過(guò)小,會(huì)使鋼網(wǎng)外表遺留局部錫膏,造成錫膏量過(guò)多。
2)設(shè)施印刷速度過(guò)快,會(huì)使下錫不充分,錫膏成型非常不好,錫膏量較少。但假如印刷速度過(guò)慢,又會(huì)造成下錫過(guò)于充分,錫膏量增加。
3)印刷時(shí)的電路板底部支撐不夠,會(huì)造成印刷時(shí)電路板向下屈曲,因此增大鋼網(wǎng)與電路板之間的空隙,錫膏會(huì)從空隙里流入電路板,造成錫量增多。
4)因?yàn)橛跋癖鎰e問(wèn)題造成電路板與鋼網(wǎng)對(duì)位非常不好,造成印刷偏移(如圖4),更容易造成燒焊橋連的發(fā)生。
經(jīng)剖析,其它不含金屬BGA部件的印制板組件運(yùn)用一樣的焊膏印刷參變量均沒(méi)有問(wèn)題,因此因素可擯除。
1)到現(xiàn)在為止均運(yùn)用貼片機(jī)施行貼片,但假如貼片壓力過(guò)大會(huì)造成錫膏沉陷較大,相鄰的錫膏容易發(fā)生橋連現(xiàn)象;2)吸嘴尺寸較小吸力不充足,設(shè)施移動(dòng)過(guò)快也會(huì)造成貼片發(fā)生偏移;3)若機(jī)器影像辨別手續(xù)沒(méi)制造好,則沒(méi)有辦法準(zhǔn)確辨別到部件的核心,造成貼片偏移,貼片偏移將直接影響
燒焊橋連的發(fā)生。經(jīng)剖析,其它不含金屬BGA部件的電路板運(yùn)用一樣的貼片工藝參變量均沒(méi)有問(wèn)題,因此因素可擯除。
因?yàn)镾MT出產(chǎn)線設(shè)施是由專業(yè)擔(dān)任職務(wù)的人施行操作出產(chǎn),涵蓋燒焊前的設(shè)施檢查驗(yàn)看,因?yàn)檫@個(gè)擔(dān)任職務(wù)的人操作問(wèn)題可以擯除。額外經(jīng)過(guò)對(duì)發(fā)生橋連的BGA事情狀況施行計(jì)數(shù),所有集中在金屬外殼的BGA上,其關(guān)鍵尺寸規(guī)格也相對(duì)集中。因?yàn)殄a球均較大,燒焊時(shí)錫球消融,金屬BGA品質(zhì)較重,相鄰的錫球也容易發(fā)生橋連現(xiàn)象。航天產(chǎn)品在出產(chǎn)運(yùn)用前均需求送有天資的單位施行二次用篩子選,能力保證出產(chǎn)運(yùn)用的元部件品質(zhì)令人滿意。
背景濕潤(rùn)程度較大造成部件潮氣滲入,燒焊過(guò)程中焊點(diǎn)的水汽向外排出會(huì)使錫球變型,造成相鄰錫球橋連。經(jīng)查在場(chǎng)溫濕潤(rùn)程度記錄,均在工藝規(guī)定的范圍內(nèi)。
經(jīng)過(guò)對(duì)貼片后和燒焊后的愛(ài)克斯射線影像做對(duì)頭比,發(fā)覺(jué)貼片后BGA位置及錫膏的塌坍均很正常,但燒焊后還是顯露出來(lái)橋連的現(xiàn)象(如圖3)。經(jīng)過(guò)比較燒焊前后的BGA高度也可以看出,BGA燒焊后高度減低了二分之一左右(如圖4),并且橋連不好均集中在金屬BGA部件,所以開(kāi)始階段的分辨斷定,發(fā)生橋連的端由就是錫量較多。不過(guò)經(jīng)過(guò)對(duì)錫膏檢驗(yàn)測(cè)定機(jī)的明確承認(rèn),其各項(xiàng)指標(biāo)均在管理控制之內(nèi)。故可確認(rèn)鋼網(wǎng)張嘴尺寸過(guò)大、厚度過(guò)厚是引動(dòng)錫球橋連的主要端由。

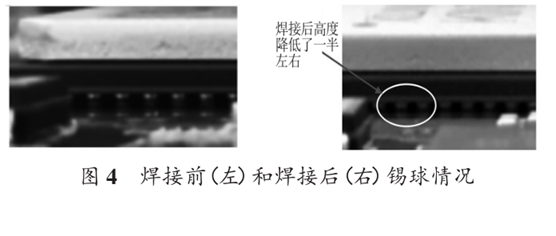
經(jīng)過(guò)上面所說(shuō)的剖析已經(jīng)找到發(fā)生橋連的主要端由,針對(duì)這一端由制定處理辦法,通過(guò)調(diào)試鋼網(wǎng)的張嘴尺寸、鋼網(wǎng)厚度兩項(xiàng)工藝參變量,通不為己甚步實(shí)行證驗(yàn)剖析的準(zhǔn)確性。
步驟1:維持鋼網(wǎng)的張嘴尺寸未變(100百分之百),將鋼網(wǎng)的厚度由0.13 mm調(diào)試為0.12 mm;步驟2:在步驟1的嘗試最后結(jié)果上,調(diào)試鋼網(wǎng)的張嘴尺寸。
為了保證減低錫膏量后,對(duì)其他部件的燒焊品質(zhì)無(wú)影響,選取了焊盤較小的金屬CCGA封裝部件和常用的BGA部件施行燒焊嘗試。選用0.12 mm厚度鋼網(wǎng),在其他工藝參變量未變的條件下,燒焊嘗試板3塊,每塊嘗試板上均有金屬封裝BGA器件和金屬封裝CCGA部件各一片。焊后的嘗試電路板外觀及檢驗(yàn)測(cè)定位置如圖5所示。燒焊完成經(jīng)檢查驗(yàn)看無(wú)問(wèn)題后行剖析,剖析過(guò)程照片兒見(jiàn)圖6~圖9所示。
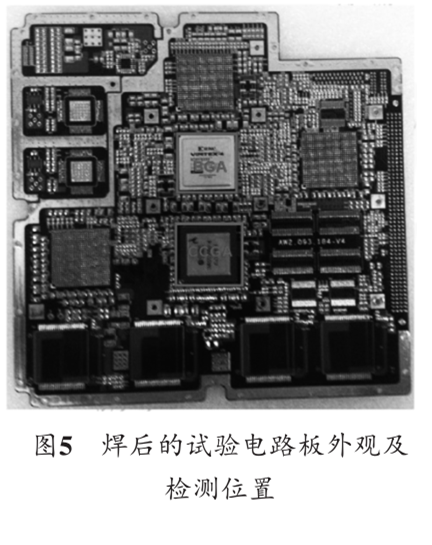
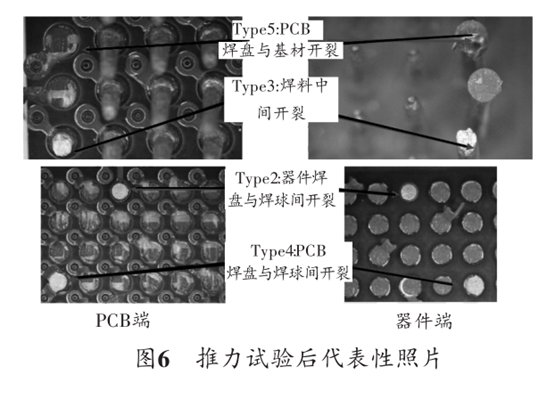
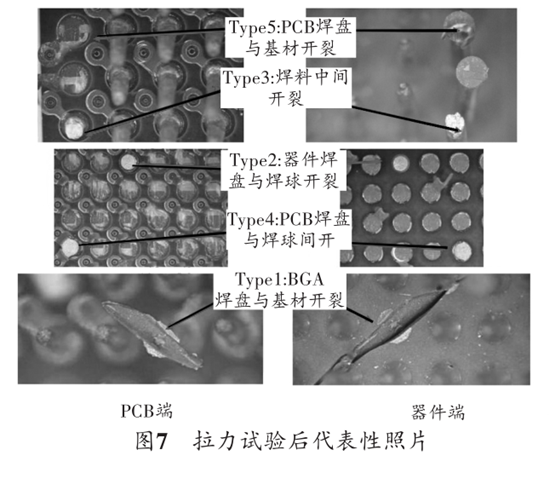

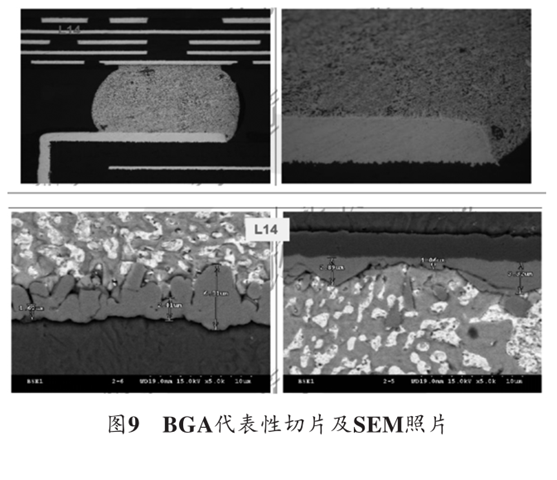
對(duì)部件施行IMC厚度、剪切力和張力測(cè)試,測(cè)試最后結(jié)果如表1所示。測(cè)試最后結(jié)果滿意IPC標(biāo)準(zhǔn)要求。

為了證驗(yàn)依照步驟1改進(jìn)后的品質(zhì)提高事情狀況,對(duì)燒焊的產(chǎn)品施行計(jì)數(shù)。共燒焊了34片金屬封裝BGA部件,仍有3片錫球發(fā)生橋連,一次燒焊符合標(biāo)準(zhǔn)率為91.17百分之百。為了進(jìn)一步提高一次燒焊符合標(biāo)準(zhǔn)率,在步驟1的基礎(chǔ)上,將鋼網(wǎng)的張嘴比例由100百分之百調(diào)試為95百分之百,在其他工藝參變量未變的條件下,燒焊嘗試板3塊,每塊嘗試板上均有金屬封裝BGA部件和金屬封裝CCGA部件各一片,燒焊完成經(jīng)檢查驗(yàn)看無(wú)問(wèn)題后行剖析,測(cè)試最后結(jié)果如表2所示,滿意IPC標(biāo)準(zhǔn)要求。
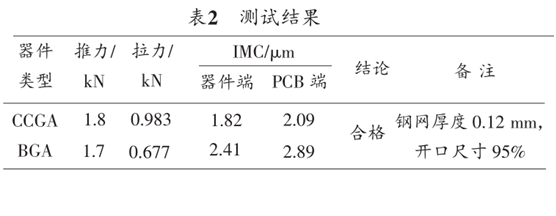
運(yùn)用再次優(yōu)化后的工藝燒焊了115片金屬封裝BGA部件,沒(méi)有再顯露出來(lái)錫球橋連事情狀況,符合標(biāo)準(zhǔn)率達(dá)100百分之百。